Mathematical
Model for Ion Implantation
- As an ion enters the surface of the wafer it
collides with atoms in the lattice and interacts with electrons in the
crystal.
- Each nuclear or electronic interaction reduces
the energy of the ion until it finally comes to rest within the target.
- Interaction with the crystal is a statistical
process and the implanted profile can be approximated by the gaussian
distribution function.
- The distribution is described mathematically
by
![]()

Where Rp
is called projected range and is equal to the average distance an ion
travels before it stops. The peak concentration Np occurs at x=Rp.
Because of the statistical nature of the process, some ions will be “lucky” and
will go beyond the projected range Rp, and some will be “unlucky”
and will fall short of Rp.
![]() DRp
is the standard deviation or the spread of distribution about Rp. It
is also called straggle.
DRp
is the standard deviation or the spread of distribution about Rp. It
is also called straggle.
DR^,
transverse straggle, defines the lateral motion of the ions and also has a
gaussian profile.
The area
under the impurity distribution curve is the implanted dose, Q, given by the
following expression:
![]()
- An arbitrary distribution N(x) can be
characterized in terms of its moments.
- The normalized first moment of an ion
distribution is the projected range, Rp.
- The second, third and fourth moments are
typically expressed in terms of three parameters: standard deviation (DRp), skewness (g) and kurtosis(b).
- Skewness measures the asymmetry of the distribution:
positive skewness places the peak of the distribution closer to the
surface than Rp.
- Kurtosis measures the flatness of the top of a
distribution.
- Note that Gaussian distributions have a
skewness of 0 and a kurtosis of 3.[2] [1]
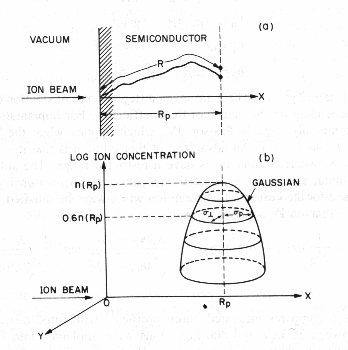
Fig. 3 Schematic views of the
ion range (a) the total path length R is longer than the projected range Rp.
(b) the stopped atom distribution is two-dimensional Gaussian.[2]
![]()
![]()
![]()
![]()